목차
AFM(Atomic Force Microscope)
1. AFM이란?
2. Contact AFM
3. Non-contact AFM
4. Intermittent-contact AFM
5. Tapping AFM
6. AFM 측정 모드별 장단점 비교
1. AFM이란?
2. Contact AFM
3. Non-contact AFM
4. Intermittent-contact AFM
5. Tapping AFM
6. AFM 측정 모드별 장단점 비교
본문내용
domain, magnetic domain이 있을 경우 시료에서 발생하는 전기장이나 자기장이 탐침에 정전기력이나 자기력을 발생시킬 수 있다. 전기력이나 자기력은 시료에 형상에 관계없이 발생하는 힘이므로, 전기력이나 자기력이 원자사이의 인력보다 강하면 순수하게 표면의 형상만을 구별해내기 어렵다. 여기서는 시료에 정전기력 이나 자기력을 발생시키는 다른 힘이 없다고 가정하고 순수한 인력에 의해 탐침과 시료의 상호 작용만을 고려한다면 non-contact AFM은 force gradient로 표면형상을 얻을 수 있다.
캔틸레버의 spring constant 가 k0 일 경우를 생각하자. 탐침이 시료표면 가까이 접근 했을 때 탐침에 반 데르 발스의 인력이 작용하기 때문에 캔틸레버의 spring constant는 원래의 값(k0)에서 새로운 spring constant keff=k0-dF/dz로 변화게 된다. 인력이 작용할 경우, dF/dz >0 이므로, keff 는 k0 보다 작아 진다.
이처럼 탐침과 시료 사이에 상호 작용에 의해 spring constant의 변화가 non-contact mode 작동에 어떤 관계가 있는지 알아 보자.
모든 물체는 고유한 공진주파수(resonance frequency :f0 )를 가지고 있다. 즉, 외부의 진동자 (여기서는 bimorph: ac 전압을 인가하여 인가된 전압의 주파수로 기계적으로 진동을 발생시키는 진동자 역할을 함 )로 캔틸레버를 진동 시킬 때, 진동자의 흔드는 주파수가 특정한 진동주파수(f0) 근처에서 캔틸레버에 전달 되는 진동이 상당히 커진다. 따라서 bimorph에 인가하는 전압의 주파수를 낮은 값에서 높은 쪽으로 변화 시키면서 각각의 주파수에서 캔틸레버가 진동하는 진폭을(lock-in으로 측정 ) 측정하고 이를 기록 한다면 캔틸레버의 공진 주파수와 주파수에 따른 특성을 알 수 있다. PSI software에서는 "NCM-Sweep" 메뉴에서 이러한 작업을 수행한다.
캔틸레버의 공진주파수는
으로 주어지며, 여기서 m은 캔틸레버의 질량이다. 따라서 <그림12>에서 탐침과 시료 사이 의 거리가 가까워지면 dF/dz가 증가하며, keff는 줄어들어 캔틸레버의 공진주파수는 f0 는 감소한다.
<그림 12. 공진주파수의 변화>
따라서 고정된 공진주파수에서 작동하는 amplitude modulation 방식(AM mode: 주로 non-contact mode에 쓰인다)에서는 공진주파수가 변하였다는 것은 amplitude 변화로 변 환된다.
4. Intermittent-contact AFM
Intermittent-contact AFM은 NC-AFM과 비슷하지만 IC-AFM의 경우 진동하는 캔틸레버의 탐침이 시료 표면에 거의 닿을 수 있도록 시료에 접근한다. <그림7>의 원자간력과 거리와 의 관계도 에서 IC-AFM이 작용하는 van der Waals 힘의 영역을 보여준다.
IC-AFM에 있어서도 NC-AFM의 경우처럼 시료와 탐침의 거리에 따라서 캔틸레버의 진동 하는 진폭이 변하는 것을 측정하여 시료의 형상을 얻는다. 일반적으로 IC-AFM은 크게 영 상화한다.
IC-AFM의 경우는 NC-AFM과는 달리 탐침이 시료에 닿으므로 시료의 표면에 손상을 줄수 있기 때문에 NC-AFM.을 이용하는 것이 바람직하다. 즉, <그림6>에서 보듯이 IC-AFM의 시료형상인 오름쪽 그림에서는 NC-AFM으로 찍은 왼쪽사진에서는 볼 수 없었던 탐침이 시료를 긁은 자리를 볼 수 있다.
Damage
<그림 12. IC-AFM의 시료형상 (오른쪽), NC-AFM의 시료형상 (왼쪽)>
5. Tapping AFM
탭핑 AFM는 보통 20nm에서 100nm의 진폭을 가지고 그것의 공진주파수 (resonance frequency)근처에서 진동하도록한 캔티레버의 끝에 부착된 팁을 샘플표면에 대하여 주사 한다. 이때 팁은 가볍게 샘플표면을 두드리는데 진동의 아래부분에서 팁은 샘플표면에 Contact AFM와 같이 접촉된다. 샘플의 높이 변화에 따라 진동 진폭이 변하게 되고 이 변화는 팁 반대편에 조사된 레이져 빔이 반사될 때에 변화를 초래하게 된다.
이 레이저 빔의 변화를 포토 다이오드 검출기에 의해 검출하여, 검출된 빔의 진폭이 초기 에 설정한 RMS(root mean square)값을 유지하도록 아래그림과 같이 귀환회로를 사용하여 제어를 하는데 이 때 각 지점(x, y)에서 제어된 스캐너의 수직위치를 컴퓨터에 저장하면 샘플표면의 3차원 영상을 얻을 수 있는 원리이다. 특징은 연질의 시료에 흠을 주지 않고 동시에 수직 해상도를 최고로 할 수 있는 AFM모드 중 가장 선명한 영상화가 가능한 모드 이다.
6. AFM 측정 모드별 장단점 비교
AFM에서 일반적으로 사용되는 측정방식으로는 Contact Mode, Non-contact Mode 가 있 으나 특히 연질의 시료인 경우에는 손상으로 정확한 시료관찰이 불가능한 문제점을 가지고 있다. 이러한 Contact Mode와 Non-contact Mode의 단점을 보완한 방법이 Digital Instruments사 의 특허인 (특허번호:5229606) Tapping Mode로서 Tip에 일정한 진동을 주 어 시료를 손상시키지 않으면서 표면 높이 차가 큰 시료나 손상되기 쉬운 시료 등에서 Contact Mode와 같은 해상력을 주면서 시료에는 전혀 손상을 주지 않는다. 아래 그림에 서 Tapping Mode가 시료의 형상을 가장 잘 묘사하고 있음을 알 수 있다.
<그림13. AFM 측정 모드별 장단점①>
액 중 Tapping Mode은 액상에서 시료를 측정할 수 있다는 장점은 물론 공기 중에서의 시 료 표면에 존재하는 표면 장력 과 정전력 등이 캔티레버에 추가되는 것을 방지하여 시료 표면에 최소의 힘이 가해지게 한다는 것을 <그림14>를 통하여 알 수 있다.
액상에서 존재하는 시료의 연구는 물론 특히 대부분의 생물시료 는 액상에서 존재하고 있 는 것을 고려할 때 이러한 Tapping Mode는 자연상태 및 생리조건하에서 시료의 구조분석 에 매우 효율적으로 사용될 수 있다.
<그림14. AFM 측정 모드별 장단점②>
캔틸레버의 spring constant 가 k0 일 경우를 생각하자. 탐침이 시료표면 가까이 접근 했을 때 탐침에 반 데르 발스의 인력이 작용하기 때문에 캔틸레버의 spring constant는 원래의 값(k0)에서 새로운 spring constant keff=k0-dF/dz로 변화게 된다. 인력이 작용할 경우, dF/dz >0 이므로, keff 는 k0 보다 작아 진다.
이처럼 탐침과 시료 사이에 상호 작용에 의해 spring constant의 변화가 non-contact mode 작동에 어떤 관계가 있는지 알아 보자.
모든 물체는 고유한 공진주파수(resonance frequency :f0 )를 가지고 있다. 즉, 외부의 진동자 (여기서는 bimorph: ac 전압을 인가하여 인가된 전압의 주파수로 기계적으로 진동을 발생시키는 진동자 역할을 함 )로 캔틸레버를 진동 시킬 때, 진동자의 흔드는 주파수가 특정한 진동주파수(f0) 근처에서 캔틸레버에 전달 되는 진동이 상당히 커진다. 따라서 bimorph에 인가하는 전압의 주파수를 낮은 값에서 높은 쪽으로 변화 시키면서 각각의 주파수에서 캔틸레버가 진동하는 진폭을(lock-in으로 측정 ) 측정하고 이를 기록 한다면 캔틸레버의 공진 주파수와 주파수에 따른 특성을 알 수 있다. PSI software에서는 "NCM-Sweep" 메뉴에서 이러한 작업을 수행한다.
캔틸레버의 공진주파수는
으로 주어지며, 여기서 m은 캔틸레버의 질량이다. 따라서 <그림12>에서 탐침과 시료 사이 의 거리가 가까워지면 dF/dz가 증가하며, keff는 줄어들어 캔틸레버의 공진주파수는 f0 는 감소한다.
<그림 12. 공진주파수의 변화>
따라서 고정된 공진주파수에서 작동하는 amplitude modulation 방식(AM mode: 주로 non-contact mode에 쓰인다)에서는 공진주파수가 변하였다는 것은 amplitude 변화로 변 환된다.
4. Intermittent-contact AFM
Intermittent-contact AFM은 NC-AFM과 비슷하지만 IC-AFM의 경우 진동하는 캔틸레버의 탐침이 시료 표면에 거의 닿을 수 있도록 시료에 접근한다. <그림7>의 원자간력과 거리와 의 관계도 에서 IC-AFM이 작용하는 van der Waals 힘의 영역을 보여준다.
IC-AFM에 있어서도 NC-AFM의 경우처럼 시료와 탐침의 거리에 따라서 캔틸레버의 진동 하는 진폭이 변하는 것을 측정하여 시료의 형상을 얻는다. 일반적으로 IC-AFM은 크게 영 상화한다.
IC-AFM의 경우는 NC-AFM과는 달리 탐침이 시료에 닿으므로 시료의 표면에 손상을 줄수 있기 때문에 NC-AFM.을 이용하는 것이 바람직하다. 즉, <그림6>에서 보듯이 IC-AFM의 시료형상인 오름쪽 그림에서는 NC-AFM으로 찍은 왼쪽사진에서는 볼 수 없었던 탐침이 시료를 긁은 자리를 볼 수 있다.
Damage
<그림 12. IC-AFM의 시료형상 (오른쪽), NC-AFM의 시료형상 (왼쪽)>
5. Tapping AFM
탭핑 AFM는 보통 20nm에서 100nm의 진폭을 가지고 그것의 공진주파수 (resonance frequency)근처에서 진동하도록한 캔티레버의 끝에 부착된 팁을 샘플표면에 대하여 주사 한다. 이때 팁은 가볍게 샘플표면을 두드리는데 진동의 아래부분에서 팁은 샘플표면에 Contact AFM와 같이 접촉된다. 샘플의 높이 변화에 따라 진동 진폭이 변하게 되고 이 변화는 팁 반대편에 조사된 레이져 빔이 반사될 때에 변화를 초래하게 된다.
이 레이저 빔의 변화를 포토 다이오드 검출기에 의해 검출하여, 검출된 빔의 진폭이 초기 에 설정한 RMS(root mean square)값을 유지하도록 아래그림과 같이 귀환회로를 사용하여 제어를 하는데 이 때 각 지점(x, y)에서 제어된 스캐너의 수직위치를 컴퓨터에 저장하면 샘플표면의 3차원 영상을 얻을 수 있는 원리이다. 특징은 연질의 시료에 흠을 주지 않고 동시에 수직 해상도를 최고로 할 수 있는 AFM모드 중 가장 선명한 영상화가 가능한 모드 이다.
6. AFM 측정 모드별 장단점 비교
AFM에서 일반적으로 사용되는 측정방식으로는 Contact Mode, Non-contact Mode 가 있 으나 특히 연질의 시료인 경우에는 손상으로 정확한 시료관찰이 불가능한 문제점을 가지고 있다. 이러한 Contact Mode와 Non-contact Mode의 단점을 보완한 방법이 Digital Instruments사 의 특허인 (특허번호:5229606) Tapping Mode로서 Tip에 일정한 진동을 주 어 시료를 손상시키지 않으면서 표면 높이 차가 큰 시료나 손상되기 쉬운 시료 등에서 Contact Mode와 같은 해상력을 주면서 시료에는 전혀 손상을 주지 않는다. 아래 그림에 서 Tapping Mode가 시료의 형상을 가장 잘 묘사하고 있음을 알 수 있다.
<그림13. AFM 측정 모드별 장단점①>
액 중 Tapping Mode은 액상에서 시료를 측정할 수 있다는 장점은 물론 공기 중에서의 시 료 표면에 존재하는 표면 장력 과 정전력 등이 캔티레버에 추가되는 것을 방지하여 시료 표면에 최소의 힘이 가해지게 한다는 것을 <그림14>를 통하여 알 수 있다.
액상에서 존재하는 시료의 연구는 물론 특히 대부분의 생물시료 는 액상에서 존재하고 있 는 것을 고려할 때 이러한 Tapping Mode는 자연상태 및 생리조건하에서 시료의 구조분석 에 매우 효율적으로 사용될 수 있다.
<그림14. AFM 측정 모드별 장단점②>















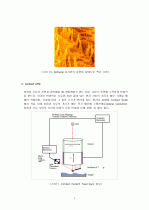















소개글