본문내용
야 한다. Unbalanced magnetron 스퍼터링 장치는 세 가지 기본 형태가 있다.
① Ⅰ 형 태 : 강한 내부 pole, 약한 외부 pole ⇒ 기판에 충돌하는 이온의 비율이 매우 낮다. (이온:증착원자=0.25:1).
② 중간 형태: 거의 균형, 보통의 magnetron
③ Ⅱ 형 태 : 약한 내부 pole, 강한 외부 pole ⇒ 낮은 기판 bias에서 기판에 충돌하는 이온의 비율이 높다(이온:증착원자=2:1).
Unbalanced magnetron 스퍼터링의 장점은 이온 에너지와 이온 유속을 독립적으로
조절할 수 있어 생성된 막의 미세 구조와 관련된 공정 변수 사이의 관계를 보다 명확하게 알 수 있다는 것이다.
( 9 ) 반응성 스퍼터링
반응성 스퍼터링은 금속 target을 이용하여 스퍼터링 할 때 불활성 가스와 동시에
반응성이 있는 가스를 흘려줌으로써 화합물 박막을 형성하는데 주로 사용된다. DC diode, RF diode, triode, magnetron, modified RF magnetron 스퍼터링 장치가 반응성 스퍼터링 장치로 이용될 수 있다. 각각의 반응성 가스를 이용해서 다음과 같은 박막들을 형성할 수 있다.
① O x i d e s ( o x y g e n ) : Al2O3, In2O3, SnO2, SiO2, Ta2O5
② N i t r i d e s ( n i t r o g e n , a m m o n i a ): TaN, TiN, AlN, Si3N4
③ C a r b i d e s ( m e t h a n e , a c e t y l e n e , p r o p a n e ) : TiC, WC, SiC
④ S u l f i d e s ( H 2 S ) : CdS, CuS, ZnS
⑤ O x y c a r b i d e s a n d o x y n i t r i d e s of Ti, Ta, Al, Si
어떤 물질이든지 반응성 스퍼터링 동안 박막은 반응성 가스의 입자가 금속 박막에 섞여 있는 고용체 합금(solid solution alloy; TaN0.01)이거나 화합물(compound; TiN)이거나 또는 이들 둘의 혼합물 형태로 형성된다. Westwood [9]는 박막이 합금이 될 지 아니면 화합물이 될지를 예측할 수 있는 방법을 제시하였다. 반응성 스퍼터링 중에는 Fig. 32(a)에서 보듯이 반응성 가스의 투입량에 따라 증착 압력(P)과 cathode 전압에 hysteresis 가 나타난다. Qr을 반응성 기체의 유량이라 하고, Qi를 불활성 가스(inert gas)의 유량이라 하자. 펌핑 속도(pumping speed)가 일정할 때, Qr이 Qr(0)에서부터 증가할 때 증착 압력은 Po로 남아있게 된다(A 상태). 그 이유는 반응성 가스가 금속과 반응하여 모두 증착되기 때문이다.
그러나 Qr이 어떤 임계값 Qr*를 넘게되면 증착 압력은 P1으로 갑자기 변한다. 이 상황에서 Qr이 감소하면 증착 압력은 반응성 가스의 유량에 따라 선형적으로 감소하다가 결국 초기압력 Po에 이른다(B 상태). 이와 같은 hysteresis 의 존재하는 이유는 A 상태와 B상태가 확연히 다르기 때문이다. A 상태에서는 모든 반응성 가스가 박막의 증착에 사용됨으로 Qr이 증가함에 따라 박막내에 존재하는 반응성 가스의 양도 증가한다. A 상태에서 B 상태로의 천이는 박막의 형성에 사용되고 남는 반응성 가스가 금속 target의 표면과 반응하여 화합물을 형성되기 때문이다. 일단 금속 target의 표면이 화합물로 덮여지면 더 이상 금속 target으로서 거동하지 못하고 화합물 target으로서 거동한다. 따라서 반응성 가스는 더 이상 박막 증착에 소모되지 못하고 챔버내에 잔류하기 때문에 Qr이 감소함에 따라 증착 압력도 감소하는 것이다. 화학 양론적 박막은 반응성 가스의
유량이 Qr* 근처일 때 얻어지게 된다.
화합물이 금속보다 이온의 충돌에 의한 2차 전자의 발생이 많이 일어나기 때문에
cathode 전압은 화합물의 경우가 더 낮아지게 된다. 반응가스의 유량에 따른 cathode 전압의 변화를 증착 압력과 관련지어 Fig. 33에 나타내었다.
TiN 을 반응성 스퍼터링 방법으로 증착할 때 반응 가스(N2)의 유량에 따른 증착 속도를 그림에 나타내었다. Target 표면이 금속 상태일 때는 증착 속도가 빠르지만 화합물 상태일 때는 증착 속도가 느리다.
반응성 스퍼터링을 잘 활용하기 위해서는 target 표면이 항상 깨끗한 금속 표면으로 유지되어야 하며 sub-stoichiometric 막의 형성과 target의 오염을 피하기 위해 공정 변수의 주의 깊은 조절이 필요하다.
( 1 0 ) 혼합 스퍼터링
Magnetron 스퍼터링 및 반응성 스퍼터링에 RF가 이용될 수 있다. RF를 사용할 경우 전장의 진폭과 방향이 다양하기 때문에 한 주기 내에서 플라즈마 내의 전자들이 받는 힘이 변하게 된다(한 주기의 일부분에만 true magnetron behavior가 존재). 따라서 플라즈마 내에서 행동하는 전자들의 힘도 다양해져 플라즈마가 더 이상 target 근처에 국한되지 않는다는 장점이 있다.
5 . 스퍼터링의 응용
스퍼터링 방법을 사용하면 막의 두께가 비교적 균일하며, 내화 재료 및 절연막의 형성도 가능하며, 합금 target을 사용할 경우 target과 같은 조성의 박막이 얻어지기 때문에 합금 target을 이용하여 합금 박막을 쉽게 형성할 수 있다는 장점이 있다. 또한 arc deposition 같이 작은 방울이 형성되지도 않는다.
스퍼터링의 target 표면의 원자를 이탈시키는 성질을 이용하여 에칭 공정(etching
process)을 수행할 수 있어 cleaning이나 thining 또는 pattern 형성에 스퍼터링이 이용될 수도 있다.
그러나 스퍼터링은 기본적으로 진공 상태를 필요로 하는 증착이므로 진공에서 견디지 못하는 target 또는 기판은 사용할 수가 없다.
Organic solid는 대부분 target으로 이용이 불가능한데, 그 이유는 이온충돌과 target의 온도 상승으로 인하여 재료가 견디지 못하고 degradation되기 때문이다.
① Ⅰ 형 태 : 강한 내부 pole, 약한 외부 pole ⇒ 기판에 충돌하는 이온의 비율이 매우 낮다. (이온:증착원자=0.25:1).
② 중간 형태: 거의 균형, 보통의 magnetron
③ Ⅱ 형 태 : 약한 내부 pole, 강한 외부 pole ⇒ 낮은 기판 bias에서 기판에 충돌하는 이온의 비율이 높다(이온:증착원자=2:1).
Unbalanced magnetron 스퍼터링의 장점은 이온 에너지와 이온 유속을 독립적으로
조절할 수 있어 생성된 막의 미세 구조와 관련된 공정 변수 사이의 관계를 보다 명확하게 알 수 있다는 것이다.
( 9 ) 반응성 스퍼터링
반응성 스퍼터링은 금속 target을 이용하여 스퍼터링 할 때 불활성 가스와 동시에
반응성이 있는 가스를 흘려줌으로써 화합물 박막을 형성하는데 주로 사용된다. DC diode, RF diode, triode, magnetron, modified RF magnetron 스퍼터링 장치가 반응성 스퍼터링 장치로 이용될 수 있다. 각각의 반응성 가스를 이용해서 다음과 같은 박막들을 형성할 수 있다.
① O x i d e s ( o x y g e n ) : Al2O3, In2O3, SnO2, SiO2, Ta2O5
② N i t r i d e s ( n i t r o g e n , a m m o n i a ): TaN, TiN, AlN, Si3N4
③ C a r b i d e s ( m e t h a n e , a c e t y l e n e , p r o p a n e ) : TiC, WC, SiC
④ S u l f i d e s ( H 2 S ) : CdS, CuS, ZnS
⑤ O x y c a r b i d e s a n d o x y n i t r i d e s of Ti, Ta, Al, Si
어떤 물질이든지 반응성 스퍼터링 동안 박막은 반응성 가스의 입자가 금속 박막에 섞여 있는 고용체 합금(solid solution alloy; TaN0.01)이거나 화합물(compound; TiN)이거나 또는 이들 둘의 혼합물 형태로 형성된다. Westwood [9]는 박막이 합금이 될 지 아니면 화합물이 될지를 예측할 수 있는 방법을 제시하였다. 반응성 스퍼터링 중에는 Fig. 32(a)에서 보듯이 반응성 가스의 투입량에 따라 증착 압력(P)과 cathode 전압에 hysteresis 가 나타난다. Qr을 반응성 기체의 유량이라 하고, Qi를 불활성 가스(inert gas)의 유량이라 하자. 펌핑 속도(pumping speed)가 일정할 때, Qr이 Qr(0)에서부터 증가할 때 증착 압력은 Po로 남아있게 된다(A 상태). 그 이유는 반응성 가스가 금속과 반응하여 모두 증착되기 때문이다.
그러나 Qr이 어떤 임계값 Qr*를 넘게되면 증착 압력은 P1으로 갑자기 변한다. 이 상황에서 Qr이 감소하면 증착 압력은 반응성 가스의 유량에 따라 선형적으로 감소하다가 결국 초기압력 Po에 이른다(B 상태). 이와 같은 hysteresis 의 존재하는 이유는 A 상태와 B상태가 확연히 다르기 때문이다. A 상태에서는 모든 반응성 가스가 박막의 증착에 사용됨으로 Qr이 증가함에 따라 박막내에 존재하는 반응성 가스의 양도 증가한다. A 상태에서 B 상태로의 천이는 박막의 형성에 사용되고 남는 반응성 가스가 금속 target의 표면과 반응하여 화합물을 형성되기 때문이다. 일단 금속 target의 표면이 화합물로 덮여지면 더 이상 금속 target으로서 거동하지 못하고 화합물 target으로서 거동한다. 따라서 반응성 가스는 더 이상 박막 증착에 소모되지 못하고 챔버내에 잔류하기 때문에 Qr이 감소함에 따라 증착 압력도 감소하는 것이다. 화학 양론적 박막은 반응성 가스의
유량이 Qr* 근처일 때 얻어지게 된다.
화합물이 금속보다 이온의 충돌에 의한 2차 전자의 발생이 많이 일어나기 때문에
cathode 전압은 화합물의 경우가 더 낮아지게 된다. 반응가스의 유량에 따른 cathode 전압의 변화를 증착 압력과 관련지어 Fig. 33에 나타내었다.
TiN 을 반응성 스퍼터링 방법으로 증착할 때 반응 가스(N2)의 유량에 따른 증착 속도를 그림에 나타내었다. Target 표면이 금속 상태일 때는 증착 속도가 빠르지만 화합물 상태일 때는 증착 속도가 느리다.
반응성 스퍼터링을 잘 활용하기 위해서는 target 표면이 항상 깨끗한 금속 표면으로 유지되어야 하며 sub-stoichiometric 막의 형성과 target의 오염을 피하기 위해 공정 변수의 주의 깊은 조절이 필요하다.
( 1 0 ) 혼합 스퍼터링
Magnetron 스퍼터링 및 반응성 스퍼터링에 RF가 이용될 수 있다. RF를 사용할 경우 전장의 진폭과 방향이 다양하기 때문에 한 주기 내에서 플라즈마 내의 전자들이 받는 힘이 변하게 된다(한 주기의 일부분에만 true magnetron behavior가 존재). 따라서 플라즈마 내에서 행동하는 전자들의 힘도 다양해져 플라즈마가 더 이상 target 근처에 국한되지 않는다는 장점이 있다.
5 . 스퍼터링의 응용
스퍼터링 방법을 사용하면 막의 두께가 비교적 균일하며, 내화 재료 및 절연막의 형성도 가능하며, 합금 target을 사용할 경우 target과 같은 조성의 박막이 얻어지기 때문에 합금 target을 이용하여 합금 박막을 쉽게 형성할 수 있다는 장점이 있다. 또한 arc deposition 같이 작은 방울이 형성되지도 않는다.
스퍼터링의 target 표면의 원자를 이탈시키는 성질을 이용하여 에칭 공정(etching
process)을 수행할 수 있어 cleaning이나 thining 또는 pattern 형성에 스퍼터링이 이용될 수도 있다.
그러나 스퍼터링은 기본적으로 진공 상태를 필요로 하는 증착이므로 진공에서 견디지 못하는 target 또는 기판은 사용할 수가 없다.
Organic solid는 대부분 target으로 이용이 불가능한데, 그 이유는 이온충돌과 target의 온도 상승으로 인하여 재료가 견디지 못하고 degradation되기 때문이다.
키워드
추천자료
 만3~5세 누리과정 영역 중 하나인 수학적 탐구에서 수와 연산의 기초개념 지도원리 및 유의점...
만3~5세 누리과정 영역 중 하나인 수학적 탐구에서 수와 연산의 기초개념 지도원리 및 유의점... [영유아프로그램개발과평가 A형] 하이스코프 프로그램의 이론적 기초, 교육목표 및 원리, 교...
[영유아프로그램개발과평가 A형] 하이스코프 프로그램의 이론적 기초, 교육목표 및 원리, 교... [영유아프로그램개발과평가 A형] 하이스코프 프로그램의 이론적 기초, 교육목표 및 원리, 교...
[영유아프로그램개발과평가 A형] 하이스코프 프로그램의 이론적 기초, 교육목표 및 원리, 교... [영유아프로그램개발과평가 A형] 하이스코프 프로그램의 이론적 기초, 교육목표 및 원리, 교...
[영유아프로그램개발과평가 A형] 하이스코프 프로그램의 이론적 기초, 교육목표 및 원리, 교... [웃음치료] 웃음치료 선정이유 및 중요성, 웃음의 이해, 웃음치료의 이해, 웃음치료의 원리
[웃음치료] 웃음치료 선정이유 및 중요성, 웃음의 이해, 웃음치료의 이해, 웃음치료의 원리 [영유아프로그램개발과평가 A형] 하이스코프 프로그램의 이론적 기초, 교육목표 및 원리, 교...
[영유아프로그램개발과평가 A형] 하이스코프 프로그램의 이론적 기초, 교육목표 및 원리, 교... [영유아프로그램개발과평가 A형] 하이스코프 프로그램의 이론적 기초, 교육목표 및 원리, 교...
[영유아프로그램개발과평가 A형] 하이스코프 프로그램의 이론적 기초, 교육목표 및 원리, 교... [영유아프로그램개발과평가 A형] 하이스코프 프로그램의 이론적 기초, 교육목표 및 원리, 교...
[영유아프로그램개발과평가 A형] 하이스코프 프로그램의 이론적 기초, 교육목표 및 원리, 교... [영유아프로그램개발과평가 B형] 몬테소리 프로그램의 이론적 기초, 교육목표 및 원리, 교육...
[영유아프로그램개발과평가 B형] 몬테소리 프로그램의 이론적 기초, 교육목표 및 원리, 교육... [영유아프로그램개발과평가 C형] 레지오 에밀리아 접근법의 이론적 기초, 교육목표 및 원리, ...
[영유아프로그램개발과평가 C형] 레지오 에밀리아 접근법의 이론적 기초, 교육목표 및 원리, ... (영유아프로그램개발과평가 B) 몬테소리 프로그램의 이론적 기초, 교육목표 및 원리, 교육과...
(영유아프로그램개발과평가 B) 몬테소리 프로그램의 이론적 기초, 교육목표 및 원리, 교육과... [유아교육과] [영유아프로그램개발과 평가 A형] 발도르프 프로그램의 이론적 기초, 교육목표 ...
[유아교육과] [영유아프로그램개발과 평가 A형] 발도르프 프로그램의 이론적 기초, 교육목표 ... [영유아프로그램개발과 평가 A형] 발도르프 프로그램의 이론적 기초, 교육목표 및 원리, 교육...
[영유아프로그램개발과 평가 A형] 발도르프 프로그램의 이론적 기초, 교육목표 및 원리, 교육...





























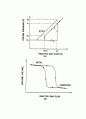











소개글