목차
반도체 CMP SLURRY 설명
시장분석
화학적 기계적 연마(CMP) 슬러리 조성에 사용되는 연마 재료의 특성
CMP 공정은 화학적(Chemical) 연마와 기계적(Mechanical) 연마
CMP 장비 및 공정 개략도
CMP 슬러리란
CMP 장비구성
CMP Consumables Market
Slurry 시장현황 (국내,해외)
Slurry Forecast (~2020)
고객 (社) Fab 위치
고객 (社) CAPA 현황
CMP 장비현황
고객 (社) 사용현황
반도체 Design rule 현황
시장분석
화학적 기계적 연마(CMP) 슬러리 조성에 사용되는 연마 재료의 특성
CMP 공정은 화학적(Chemical) 연마와 기계적(Mechanical) 연마
CMP 장비 및 공정 개략도
CMP 슬러리란
CMP 장비구성
CMP Consumables Market
Slurry 시장현황 (국내,해외)
Slurry Forecast (~2020)
고객 (社) Fab 위치
고객 (社) CAPA 현황
CMP 장비현황
고객 (社) 사용현황
반도체 Design rule 현황
본문내용
CMP(화학적 기계적 연마)는 모든 실리콘 반도체 생산 공장(SEMI fab)의 필수 요소입니다. 리소그래피와 박막 증착을 사용하여 만들어진 집적 회로는 기질과 침전된 층에서 원하는 평면성을 달성하기 위해 항상 CMP를 사용합니다. CMP 슬러리는 일반적으로 화학 반응 용액에 산재된 나노 크기의 연마 분말로 구성됩니다. 화학적 에칭으로 인해 재료를 부드럽게 하는 한편, 기계적 마모가 재료를 제거하여 지형과 표면을 표면을 평평하게 합니다. 화학적 에칭은 등방성이며 표면 지형을 평평하게 하지 않고, 기계적 마모는 표면을 평평하게 하지만 표면에 결함을 유발할 수 있습니다. 올바르게 설계된 CMP 프로세스는 표면 결함을 발생시키지 않고 평면성을 달성할 수 있습니다.
연마 입자의 크기 분포는 CMP 슬러리에서 중요한 설계 매개 변수로서, 재료 제거 속도 및 표면 결함과 같은 주요 지표에 영향을 미칩니다. 또 다른 중요한 매개 변수는 슬러리 내 입자의 분산과 응집입니다. 응집된 입자는 대형 입자처럼 동작하여 연마 공정 중 표면이 손상됩니다.
CMP 연마성 입자의 일반적인 크기 범위는 10-250나노미터입니다. 몇 가지 입자 크기 측정 기술은 이 범위에서 다양한 정확도 및 정밀도로 입자 크기를 측정할 수 있습니다. 레이저 회절, 동적 광산란, 소각 X선 산란은 이 크기 범위에서 높은 정확도와 정밀도를 제공하는 핵심 기술입니다.
응집은 일반적으로 ppm 범위에서 최대 10마이크론의 과대 응집물을 자주 발생시킬 수 있습니다. 제타 전위를 사용하여 입자 응집을 방지하는 슬러리 안정성을 측정할 수 있습니다. 대형 입자는 광산란 또는 영상 기법을 사용하여 검출할 수 있습니다.
연마 입자의 크기 분포는 CMP 슬러리에서 중요한 설계 매개 변수로서, 재료 제거 속도 및 표면 결함과 같은 주요 지표에 영향을 미칩니다. 또 다른 중요한 매개 변수는 슬러리 내 입자의 분산과 응집입니다. 응집된 입자는 대형 입자처럼 동작하여 연마 공정 중 표면이 손상됩니다.
CMP 연마성 입자의 일반적인 크기 범위는 10-250나노미터입니다. 몇 가지 입자 크기 측정 기술은 이 범위에서 다양한 정확도 및 정밀도로 입자 크기를 측정할 수 있습니다. 레이저 회절, 동적 광산란, 소각 X선 산란은 이 크기 범위에서 높은 정확도와 정밀도를 제공하는 핵심 기술입니다.
응집은 일반적으로 ppm 범위에서 최대 10마이크론의 과대 응집물을 자주 발생시킬 수 있습니다. 제타 전위를 사용하여 입자 응집을 방지하는 슬러리 안정성을 측정할 수 있습니다. 대형 입자는 광산란 또는 영상 기법을 사용하여 검출할 수 있습니다.
















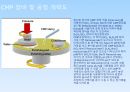
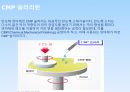



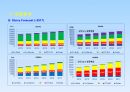















소개글