
-
1
-
2
-
3
-
4
-
5
-
6
-
7
-
8
-
9
-
10
-
11
-
12
-
13
-
14
-
15
-
16
-
17
-
18
-
19
-
20
-
21
-
22
-
23
-
24
-
25
-
26
-
27
-
28
-
29
-
30
-
31
-
32
-
33
-
34
-
35
-
36
-
37
-
38
-
39
-
40
-
41
-
42
-
43
-
44
-
45
-
46
-
47
-
48
-
49
-
50
-
51
-
52
-
53
-
54
-
55
-
56
-
57
-
58
-
59
-
60
-
61
-
62
-
63
-
64
-
65
-
66
-
67
-
68
-
69
-
70
-
71
-
72
-
73
-
74
-
75
-
76
-
77
-
78
-
79
-
80
-
81
-
82
-
83
-
84
-
85
-
86
-
87
-
88
-
89
-
90
-
91
-
92
-
93
-
94
-
95


목차
1.CMP 공정 개요
2.CMP 기본 원리 및 구성 요소
3.CMP 공정 변수 및 제어
4.CMP 공정의 적용
5.차세대 CMP 연구 방향
2.CMP 기본 원리 및 구성 요소
3.CMP 공정 변수 및 제어
4.CMP 공정의 적용
5.차세대 CMP 연구 방향
본문내용
CMP 설명
Chemical Mechanical Polishing
Chemical Mechanical Planarization
Wafer를 화학적 반응(Chemical)과 기계적 힘(Mechanical)을 이용하여 평탄하게(Planarization) 연마(Polishing)하는 반도체 공정.
(Effective) Pattern Density 의 차이← Pattern Layout, Dummy, 증착 방식 및 Pattern 크기 → CMP Simulator
Planarization Efficiency 의 차이← Pad, Slurry, Pressure etc.
Current End Point Detection Methods
Theoretical Background of Optical EPD
Oxide CMP Using Silica Based Slurry
Hydration of Oxide Layer : Softening the Surface
Silica Abrasive : Mechanical Abrasion of Hydrated Oxide Layer
→ Increase Hydration Layer : Increment of Oxide RR
Practical Application of Ceria Based Slurry
Anion (R-COO-) Can Passivate Si3N4 Selectively → High Selectivity
Polysilicon structure is vulnerable to chemical attack
▶ Polysilicon surface (≡Si-Si≡ and ≡Si-H): Hydrophobic
W Removal Rate with Dual Oxidant
Introduction of Al Damascene Process
Al Material is Vulnerable to Mechanical and Chemical Attacks
Severe Scratch, Corrosion, Pitting Defects After CMP Process
Restriction in Using Strong Cleaning Chemicals for Defect Reduction
Requirements for Future Technology
CMP Simulator 개발
Dishing Mechanism 연구
Slurry Flow Simulation
Recess Free Poly Slurry 개발
High Planarity Slurry 개발
High Planarity W Slurry 개발
High Selectivity Slurry 개발
Pending Issue of FA WEB - Scratch
PIV 기법을 이용한 Slurry 내부 유동 연구
Slurry Recycling
slurry capture system
Chemical Mechanical Polishing
Chemical Mechanical Planarization
Wafer를 화학적 반응(Chemical)과 기계적 힘(Mechanical)을 이용하여 평탄하게(Planarization) 연마(Polishing)하는 반도체 공정.
(Effective) Pattern Density 의 차이← Pattern Layout, Dummy, 증착 방식 및 Pattern 크기 → CMP Simulator
Planarization Efficiency 의 차이← Pad, Slurry, Pressure etc.
Current End Point Detection Methods
Theoretical Background of Optical EPD
Oxide CMP Using Silica Based Slurry
Hydration of Oxide Layer : Softening the Surface
Silica Abrasive : Mechanical Abrasion of Hydrated Oxide Layer
→ Increase Hydration Layer : Increment of Oxide RR
Practical Application of Ceria Based Slurry
Anion (R-COO-) Can Passivate Si3N4 Selectively → High Selectivity
Polysilicon structure is vulnerable to chemical attack
▶ Polysilicon surface (≡Si-Si≡ and ≡Si-H): Hydrophobic
W Removal Rate with Dual Oxidant
Introduction of Al Damascene Process
Al Material is Vulnerable to Mechanical and Chemical Attacks
Severe Scratch, Corrosion, Pitting Defects After CMP Process
Restriction in Using Strong Cleaning Chemicals for Defect Reduction
Requirements for Future Technology
CMP Simulator 개발
Dishing Mechanism 연구
Slurry Flow Simulation
Recess Free Poly Slurry 개발
High Planarity Slurry 개발
High Planarity W Slurry 개발
High Selectivity Slurry 개발
Pending Issue of FA WEB - Scratch
PIV 기법을 이용한 Slurry 내부 유동 연구
Slurry Recycling
slurry capture system
추천자료
 반도체환경기술의 국내외 최근동향 및 향후 기술개발방향
반도체환경기술의 국내외 최근동향 및 향후 기술개발방향 [국제학] 중국의 역사왜곡 동북공정 비판
[국제학] 중국의 역사왜곡 동북공정 비판 [디지털][디지털혁명][디지털화][디지털경제][디지털시장][디지털사회]디지털혁명(디지털화)...
[디지털][디지털혁명][디지털화][디지털경제][디지털시장][디지털사회]디지털혁명(디지털화)... 유아들에게 사회적 개념, 기술, 행동들을 왜 가르쳐야 하는지 그리고 그것들을 가르치기 위한...
유아들에게 사회적 개념, 기술, 행동들을 왜 가르쳐야 하는지 그리고 그것들을 가르치기 위한... 반도체 공정의 이해
반도체 공정의 이해 중학교(중등) 체육과(체육교육)의 특징과 목표, 중학교(중등) 체육과(체육교육)의 교육실태와...
중학교(중등) 체육과(체육교육)의 특징과 목표, 중학교(중등) 체육과(체육교육)의 교육실태와... [경영학원론][기업윤리]기업의 불공정사례 LG 중소기업 상생방안
[경영학원론][기업윤리]기업의 불공정사례 LG 중소기업 상생방안 [사회복지정책론] 스칸디나비아 복지국가에 대해 설명하시오 (스칸디나비아)
[사회복지정책론] 스칸디나비아 복지국가에 대해 설명하시오 (스칸디나비아) [2020 교육사회학3공통][기말시험][출처표기] 1.갈등이론을 간단히 설명하고, 갈등이론을 편 ...
[2020 교육사회학3공통][기말시험][출처표기] 1.갈등이론을 간단히 설명하고, 갈등이론을 편 ...
















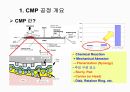

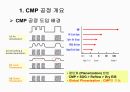



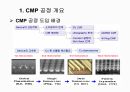
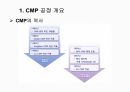






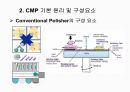











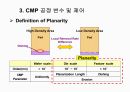

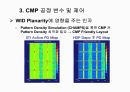












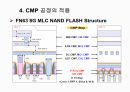

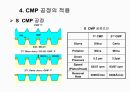


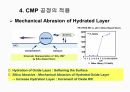


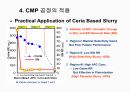

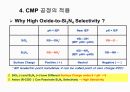
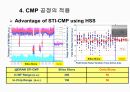
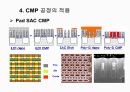
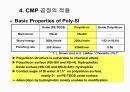


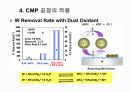
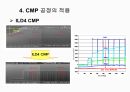


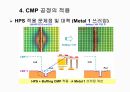
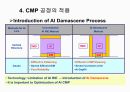

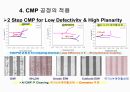

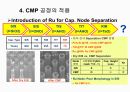
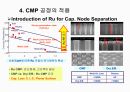






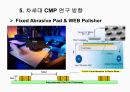
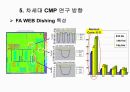

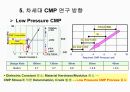

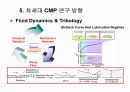







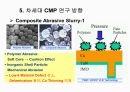
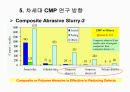









소개글