목차
1. Introduction
2. Experiment
3. Data
4. Discussion
5. Conclusions
2. Experiment
3. Data
4. Discussion
5. Conclusions
본문내용
The optimum annealing temperature for the maximum PL yield strongly depends on the film thickness and varies from 800 to 1200 °C.
The PL intensity is directly related to the content of the Si–-N bonds in the SiNx films.
Excessively high annealing temperatures lead to weakened Si–-N bonds
(which effectively control the PL intensity)
in thinner SiNx films, which eventually results in a lower PL intensity.
The PL intensity is directly related to the content of the Si–-N bonds in the SiNx films.
Excessively high annealing temperatures lead to weakened Si–-N bonds
(which effectively control the PL intensity)
in thinner SiNx films, which eventually results in a lower PL intensity.
추천자료
 [일반물리]전기저항
[일반물리]전기저항 트랜지스터에 관한 모든 것
트랜지스터에 관한 모든 것 Plasma DC Glow Discharge RF Discharge Reference
Plasma DC Glow Discharge RF Discharge Reference 질화합물의 합성
질화합물의 합성 [화학공학/재료공학]전기전도도와 열전도도의 관한 termpaper 자료
[화학공학/재료공학]전기전도도와 열전도도의 관한 termpaper 자료 열무게분석법[TGA(ThermoGravimetric Analysis)]
열무게분석법[TGA(ThermoGravimetric Analysis)] Differential Scanning Calorimetry(DSC)
Differential Scanning Calorimetry(DSC) 『열전현상의 효과와 특징』에 대하여
『열전현상의 효과와 특징』에 대하여 (A+ 분산분석) 일원배치법
(A+ 분산분석) 일원배치법 가스센서의 특징
가스센서의 특징 계측공학 hw3
계측공학 hw3 hall effect 실험 예비 보고서 & 결과 보고서 & introduction
hall effect 실험 예비 보고서 & 결과 보고서 & introduction 화학 - 금속 산화물 및 질화물의 합성 및 특성 조사
화학 - 금속 산화물 및 질화물의 합성 및 특성 조사 Beauty Cool 마케팅
Beauty Cool 마케팅















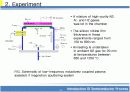












소개글