목차
◎ 반도체 공정
1. 반도체
2. 반도체 소자의 제조 과정
◎ 금속배선공정에서의 Low-k material 특성 및 필요성
1. 반도체 소자
2. 저유전 물질 ( Low-k material )
1. 반도체
2. 반도체 소자의 제조 과정
◎ 금속배선공정에서의 Low-k material 특성 및 필요성
1. 반도체 소자
2. 저유전 물질 ( Low-k material )
본문내용
진공은 k 값이 1인 dielectric material 로 생각하면 될 것이다.
2) 유전물질의 응용
일반적으로 반도체에 있어서 dielectric material은 크게 두 가지 경우에 있어서 사용되고 있다.
그 하나가 capacitor dielectric material (High-k 응용)이고 나머지가 interlevel dielectric material (ILD:Low-k 응용)
① capacitor dielectric material
소자의 조밀도가 증가함에 따라 pattern size는 감소하게 되고 이에 따라 capacitor에서 capacitor 값은 점점 감소하게 된다.
C = Q / V = A / d
* A(= 단면적 = L*w), d(= 두께), (=진공이 아닌 일반적인 물질에서의 유전율)
소자의 size L이 줄어듦에 따라 두가지 방법으로 capacitor를 유지할 수 있다.
a. d를 줄이는 방법이다. 그러나 이는 break down voltage를 떨어뜨려 소자의 특성을 낮추게 되므로 좋지않은 방법이다.
b. 유전율이 큰 물질을 사용하는 것이다. 이것은 = k* 0이므로 높은 k 값의 물질을 사용하는 것을 의미한다.
② interlevel dielectric
앞에서 언급하였듯이 소자의 직접도가 증가함에 따라 transistor의 gate length가 감소하게 되고 transistor
switching time 또한 점점 빨라지는 추세이다.
이러한 gate length의 감소는 RC delay에서 저항을 증가시킴으로써 커지게된다.
RC delay의 증가는 RC delay로인한 신호지연의 문제 뿐만 아니라 다른 문제도 발생하게 되는데 배선간격이 좁아짐에 따라 cross talk noise 문제 및 power consumption 문제 등이 그것이다.
RC delay에의한 신호지연 및 cross talk 문제의 해결 방법으로는 두 가지 방법이 있는데 R과 C의 개선이다.
a. R의 개선은 Cu 배선의 도입이 주종을 이루고 있는데 이는 현제 Al 배선에서의 저항을 약 37%정도 개선가능하다.
b. C의개선은 k값이 작은 물질을 사용하는 것으로 현재 여러 가지 물질이 연구되고 있다.
3) 저유전 물질의 필요성
최근에 구리의 전기도금(electroplating) 기술과 구리 금속의 식각 공정을 피할 수 있는 dual damascene(매입 공정, 상감공정 : 절연층에 구멍을 제작한 후 도체인 배선 물질을 나중에 매입하는 방식의 공정)에 의한 배선 공정이 개발되어 구리의 본격적인 반도체 배선물질로의 사용이 가능하여 졌다. 이 공정은 금속 식각에서 발생하는 문제를 쉽게 해결할 수 있기 때문에 CMP(chemical mechanical planarization : 화학적기계연마법) 공정을 이용하여야 함에도 불구하고 기존의 공정보다 약 20% 이상의 가격 절감이 가능할 것이라고 추정된다. 특히 다층 배선구조를 필요로 하는 논리 회로의 제작에 더욱 유용한 것으로, 1997년 미국의 IBM과 Motorola사가 damascene공정과 구리 배선을 사용한 반도체 칩을 발표하고 Cu Chip을 상용화한다는 계획을 발표한 이후 본격적인 "구리시대(Copper Age)"가 시작되었다. 이에 전세계의 수많은 반도체 제조업체가 지대한 관심을 갖고 있으며, 고속 칩을 효율적으로 제작하기 위해서는 전기저항이 적은 Cu interconnet 뿐만 아니라 전기용량이 작은 저유전 물질의 개발이 병행되어야 하므로 향후 반도체 재료 시장에 엄청난 영향을 미칠 것으로 예상하고 있으며, 국내에서도 이러한 새로운 개념의 Cu Chip 제조에 필요한 저유전 물질을 조기에 개발함으로써 새로운 반도체 시장의 변화에 능동적으로 대처할 수 있다는 점이 있다. 구리 배선 공정에서, 저유전 물질의 중요성은 배선재료인 알루미늄만 구리로 대체해서는 고집적화/고속화의 목표를 달성할 수 없고, 반드시 저유전 물질의 사용이 동시에 이루어져야만 가능하다는 것이다. 이는 첫째, 배선물질의 저항과 절연막의 정전용량의 곱으로 표시되는 RC 신호지연의 감소가 소자의 고속화를 위한 필수사항이기 때문이다. 알루미늄과 SiO2를 그대로 사용할 경우, 선폭 130 nm의 소자에서 22 psec의 신호지연이 예측된다
둘째, 저유전 물질을 사용하면 상호 신호방해(cross-talk)를 방지할 수 있어 회로밀도의 증가로 인한 고집적화/소형화가 가능하고, 궁극적으로는 가격절감 및 칩성능의 획기적 향상을 성취할 수 있다
2) 유전물질의 응용
일반적으로 반도체에 있어서 dielectric material은 크게 두 가지 경우에 있어서 사용되고 있다.
그 하나가 capacitor dielectric material (High-k 응용)이고 나머지가 interlevel dielectric material (ILD:Low-k 응용)
① capacitor dielectric material
소자의 조밀도가 증가함에 따라 pattern size는 감소하게 되고 이에 따라 capacitor에서 capacitor 값은 점점 감소하게 된다.
C = Q / V = A / d
* A(= 단면적 = L*w), d(= 두께), (=진공이 아닌 일반적인 물질에서의 유전율)
소자의 size L이 줄어듦에 따라 두가지 방법으로 capacitor를 유지할 수 있다.
a. d를 줄이는 방법이다. 그러나 이는 break down voltage를 떨어뜨려 소자의 특성을 낮추게 되므로 좋지않은 방법이다.
b. 유전율이 큰 물질을 사용하는 것이다. 이것은 = k* 0이므로 높은 k 값의 물질을 사용하는 것을 의미한다.
② interlevel dielectric
앞에서 언급하였듯이 소자의 직접도가 증가함에 따라 transistor의 gate length가 감소하게 되고 transistor
switching time 또한 점점 빨라지는 추세이다.
이러한 gate length의 감소는 RC delay에서 저항을 증가시킴으로써 커지게된다.
RC delay의 증가는 RC delay로인한 신호지연의 문제 뿐만 아니라 다른 문제도 발생하게 되는데 배선간격이 좁아짐에 따라 cross talk noise 문제 및 power consumption 문제 등이 그것이다.
RC delay에의한 신호지연 및 cross talk 문제의 해결 방법으로는 두 가지 방법이 있는데 R과 C의 개선이다.
a. R의 개선은 Cu 배선의 도입이 주종을 이루고 있는데 이는 현제 Al 배선에서의 저항을 약 37%정도 개선가능하다.
b. C의개선은 k값이 작은 물질을 사용하는 것으로 현재 여러 가지 물질이 연구되고 있다.
3) 저유전 물질의 필요성
최근에 구리의 전기도금(electroplating) 기술과 구리 금속의 식각 공정을 피할 수 있는 dual damascene(매입 공정, 상감공정 : 절연층에 구멍을 제작한 후 도체인 배선 물질을 나중에 매입하는 방식의 공정)에 의한 배선 공정이 개발되어 구리의 본격적인 반도체 배선물질로의 사용이 가능하여 졌다. 이 공정은 금속 식각에서 발생하는 문제를 쉽게 해결할 수 있기 때문에 CMP(chemical mechanical planarization : 화학적기계연마법) 공정을 이용하여야 함에도 불구하고 기존의 공정보다 약 20% 이상의 가격 절감이 가능할 것이라고 추정된다. 특히 다층 배선구조를 필요로 하는 논리 회로의 제작에 더욱 유용한 것으로, 1997년 미국의 IBM과 Motorola사가 damascene공정과 구리 배선을 사용한 반도체 칩을 발표하고 Cu Chip을 상용화한다는 계획을 발표한 이후 본격적인 "구리시대(Copper Age)"가 시작되었다. 이에 전세계의 수많은 반도체 제조업체가 지대한 관심을 갖고 있으며, 고속 칩을 효율적으로 제작하기 위해서는 전기저항이 적은 Cu interconnet 뿐만 아니라 전기용량이 작은 저유전 물질의 개발이 병행되어야 하므로 향후 반도체 재료 시장에 엄청난 영향을 미칠 것으로 예상하고 있으며, 국내에서도 이러한 새로운 개념의 Cu Chip 제조에 필요한 저유전 물질을 조기에 개발함으로써 새로운 반도체 시장의 변화에 능동적으로 대처할 수 있다는 점이 있다. 구리 배선 공정에서, 저유전 물질의 중요성은 배선재료인 알루미늄만 구리로 대체해서는 고집적화/고속화의 목표를 달성할 수 없고, 반드시 저유전 물질의 사용이 동시에 이루어져야만 가능하다는 것이다. 이는 첫째, 배선물질의 저항과 절연막의 정전용량의 곱으로 표시되는 RC 신호지연의 감소가 소자의 고속화를 위한 필수사항이기 때문이다. 알루미늄과 SiO2를 그대로 사용할 경우, 선폭 130 nm의 소자에서 22 psec의 신호지연이 예측된다
둘째, 저유전 물질을 사용하면 상호 신호방해(cross-talk)를 방지할 수 있어 회로밀도의 증가로 인한 고집적화/소형화가 가능하고, 궁극적으로는 가격절감 및 칩성능의 획기적 향상을 성취할 수 있다
추천자료
 평판형 글로우 방전 플라즈마 공정에서의 미립자 오염에 관한 연구
평판형 글로우 방전 플라즈마 공정에서의 미립자 오염에 관한 연구 리소그래피의 원리와 공정
리소그래피의 원리와 공정 최근 리소그라피의 동향에 대하여
최근 리소그라피의 동향에 대하여 나노 임프린트[Nano Imprint]공정에 대한 조사 자료
나노 임프린트[Nano Imprint]공정에 대한 조사 자료 산화 실험
산화 실험 Si(p-type) 기판위에 MOCVD TiN / MOCVD Co를 In-Situ 공정으로 증착 후 열처리 온도에 따른 ...
Si(p-type) 기판위에 MOCVD TiN / MOCVD Co를 In-Situ 공정으로 증착 후 열처리 온도에 따른 ... [공학기술]박막 공정(THIN-FILM PROCESS) 조사보고서
[공학기술]박막 공정(THIN-FILM PROCESS) 조사보고서 DMD(digital micromirror device)의 구조 동작원리 및 공정
DMD(digital micromirror device)의 구조 동작원리 및 공정 유기 태양전지(Organic Solar Cell)의 동작원리 및 공정단계와 현재의 문제점, 그리고 향후 ...
유기 태양전지(Organic Solar Cell)의 동작원리 및 공정단계와 현재의 문제점, 그리고 향후 ... LED 제조 공정
LED 제조 공정 촉매(Catalyst)공정에 대해
촉매(Catalyst)공정에 대해 Flip Chip 및 Flip Chip 공정
Flip Chip 및 Flip Chip 공정 MOCVD 공정 (Metal Organic Chemical Vapor Deposition)
MOCVD 공정 (Metal Organic Chemical Vapor Deposition) [윤리]윤리(ethics)라는 개념을 기업활동과 관련하여 공정, 정의, 양심, 선행, 에티켓, 도덕,...
[윤리]윤리(ethics)라는 개념을 기업활동과 관련하여 공정, 정의, 양심, 선행, 에티켓, 도덕,...















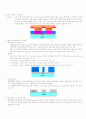















소개글